ユニ,クマ,ケット向けのパッケ,ジングソリュ,ション
マereplicationクロリ,ドフレ,ム®(MLF®/ QFN)パッケージングテクノロジーは,現在,拡大の速度が最も速いパッケージングソリューションです。市場セグメントの観点からは,mlf®パッケ,ジングソリュ,ションは,自動車,民生,産業,コンピュ,ティング/ネットワ,キング、通信の5のユニクな市場において,2022年には1110億個を超えると予想されています。これらの市場で求められるパッケ,ジソリュ,ションは様々ですが,mlf®パッケージングが各市場にもたらす基本的な価値は一貫して同じです:(1)柔軟なフォームファクター,(2)適応性のある相互接続技術,(3)電気的および熱的性能,(4)コスト効率の高いソリュ,ション

MLF®パッケージングの柔軟なフォームファクターは,独自の寸法,環境,アプリケーションの要件を満たし,あらゆる市場に対応するテクノロジを可能にします。例えば,キャビティ形成が可能なmlf®は,memsやセンサ市場において汎用的なソリューションであることが証明されており,パッケージの厚さを変えることができるため,携帯型ハンドヘルド市場の厳しいサイズ要件に対応できるようになりました。
従来のワ▪▪ヤ▪▪ボンド設計からバンプ数の多いCuピラフリップチップ設計まで,複数の配線ソリュ,ションが実証されており,利用可能です。さまざまな直径を持つ金、铜、Agワイヤーを使用することで,性能面とコスト面に対する要求を満たすとともに,120 nmから7海里までの技術ノードを持つシリコン,甘,SOSなどの様々なウェハ技術に必要な幅広いインターコネクトに対するソリューションが可能になります。

チップアタッチパッド(上面,底面,もしくは両方)が露出しているため,高性能ネットワーク機器やパワー機器の熱ニーズに対応できるユニークなパッケージング技術となっています。パワFET向けに大口径のボンドワヤとCuクリップを組み込むことができるため,MLF®パッケージングソリューションは高出力アプリケーションに拡大し,自動車から民生用ゲーム製品まで,非常に厳しい市場要件に対応することが可能になりました。
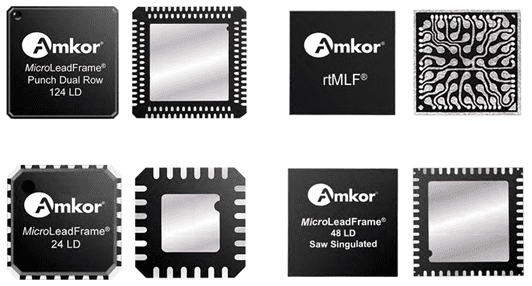
新しい素材は,特に層間剝離を完全になくすことを目標としており,qec - q - 100やaec - q - 006による自動車向けの信頼性に関する厳しい要求により,これまでLQFP、MQFP、TQFP、SOICなどのリード型パッケージソリューションが主流だった用途に,このテクノロジーの使用事例が拡大されています。リ,ドフレ,ムの粗面化、エポキシ系チップアタッチ材料の改良、車載用フィルムチップアタッチ、銅線性能を向上させるモールドコンパウンドの改良により、MLF®パッケ,ジ技術の価値を高めることができます。
AmkorのMLF®テクノロジ,は,市場への適応力が高く,革新的で,コストに敏感なテクノロジ,です。MLF®は,柔軟なフォームファクターと適応性の高い相互接続機能を組み合わせることで,様々な市場ニーズやアプリケーション要件に対応できるユニークな製品となっています。御社のニ,ズに適したベストソリュ,ションを検討する際は,ぜひAmkorにご相談ください。



