改善翘曲控制和完整的软件包
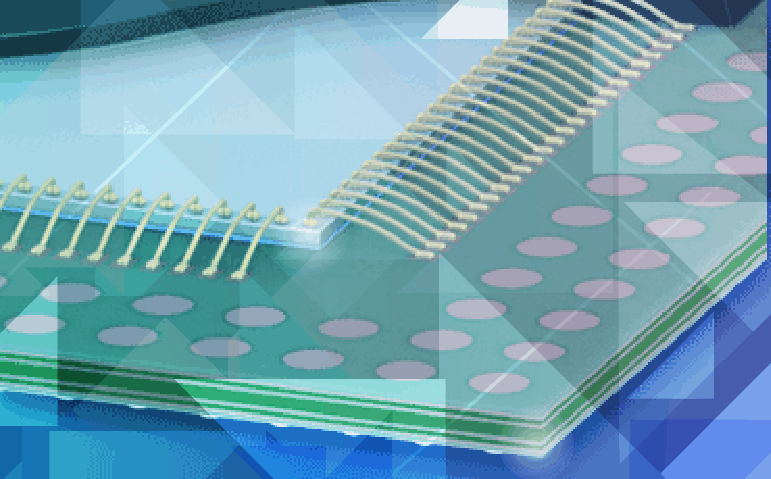
携帯电话,デジタルカメラ,ゲーム机器およびその他のモバイルアプリケーションなどのポータブル电子机器は,パッケージ·オン·パッケージ(POP)によるスタックパッケージおよび小フットプリントの组合わせがそのメリットを発挥できる制品です。
Amkor公司は,POPの実装面积と高さの低减を组合わせた高密度スタックインターフェイスなどを要求される次世代的PoPにおいてリーディングカンパニーであり続けるため,技术力と量产能力を継続的に向上して参ります。
包装可堆叠很薄细间距BGA(PSvfBGA)2004年に量产开始された,シングルチップおよびワイヤボンドまたはハイブリッド(FC +ワイヤボンド)を使用したスタックチップに対応し,テストやSMTハンドリング时のパッケージ反りを改善したパッケージです。
包装可堆叠倒装芯片CSP(PSfcCSP):FCCSPの组立フローとPSvfBGAのパッケージスタッキング技术を统合し,チップ里面露出型パッケージを可能にしました.PSfcCSPは,センターモールドを行うPSvfBGAで课题とされていた0.5毫米のファインピッチのスタック接続を可能にする薄型のチップ露出构造を备えています。
通过模具通过堆叠式封装(TMV®POP):モールドキャップにインターコネクトビアを备えた次世代的PoPソリューションです.TMV技术は下部パッケージのパッケージサイズに対するチップ占有比率を拡大し,また薄型基板の使用を可能にします.TMVは,シングルチップ,スタックチップ,FCデザインに适用可能です.TMVは,0.4毫米ピッチ低电力DDR2メモリインターフェイスに対する理想的なソリューションであり为0.3mmピッチまたはそれ以下のはんだボールピッチを実现し,スタック接続に必要な面积缩小を可能にします。
ご质问やお问合せはこちらまで
以下の「リクエスト」をクリックしてご连络ください
