增加装备的导电极密度

宽带隙(WBG)繁体技术对功率功率装配出来了新的和机构。开发包括碘化铅(SiC)和锰化(GaN)在的技术,比硅MOSFET具有更高的装备(FOM),而且扩展了对功率功率电子产品的效率,输出功率和/或开关频率,以及以及作用温度。
由于功耗降低,特价尺寸功率器材可以更高电力负荷。例如,相对于碱基,采相对于氮,氮氮的电气系统ーーーー氮的电气源。技术可以克服由无线系统等低功率 (50W) 端到中功率端,甚至高功率水平所带来的系统挑战。对 5G 系统的兼容性使其能够完美适应精密的中低功率封装。类似地,SIC 的功率控制能力高于硅基 MOSFET,而且对很多应用都有先进封装要求。WBG 器件的好处与优势需要新的封装选项,来最大限度地挖掘出整个电源系统的价值。
目前的离散功率封装受限于夹片,焊线和焊点的电气性能。一般来说,离散封装遵循着更大尺寸/体积和更强功率处理能力之间相互关联的设计理念。不过,此类更高效的繁体管技术提供在相同尺寸的装备中间更高度的能气,或者或者大厦减小其外研格。
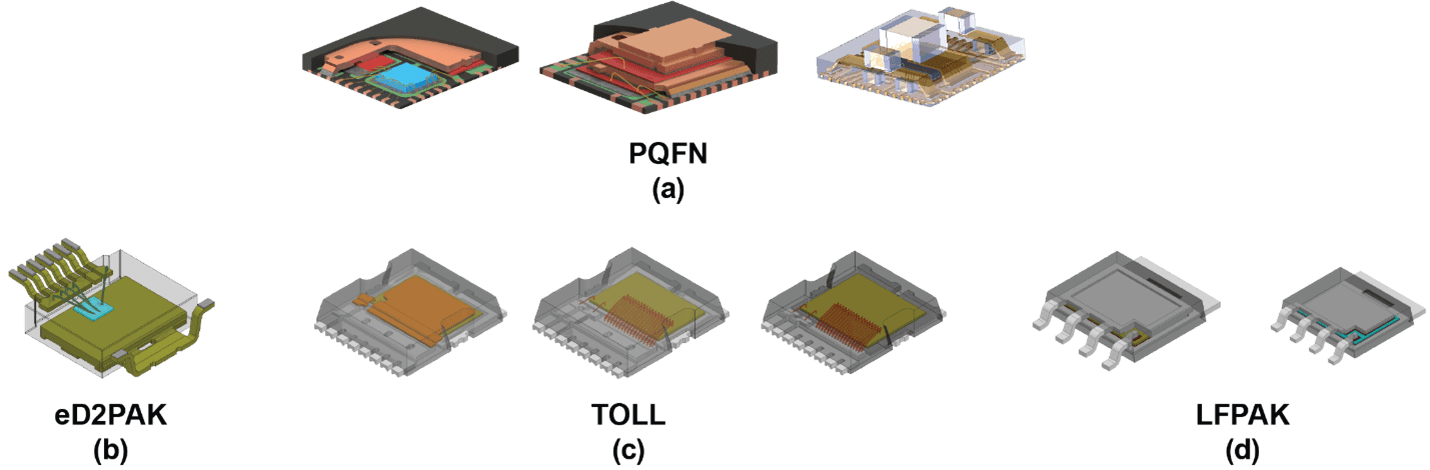
图1。可用的功率离散包括(一种)pqfn演变,(b)带散热片的ed2pak,
(C)Toll变化,以及(d)LFPAK。
适用于大大限制提高传统功率装配的总传导率,晶片设计的源极和漏极需要在100%或接近100%的可用空间中间连接到电池承载。在传统上,通孔加入电线数量,电线直径或者将固定到源极或漏极的夹片尺寸大大化可以实现这这一点。
要,促和漏极的,必须,源极和漏极的总传导率最,源极和电池被,或,源极和电池,其次,源极和电池被取消,或在进行的。长度/厚度。第三,需要增加装配的传导传导密度。在下文中,我们检视了所使使用的大量功率专用词。

表1。现有功率装配的比较数。
要在大大程度上又和电气,包装体内最好极度采更多材料。所在,装载所所功率很少很少25%(见表1)。
我们需要新的衣服格式来将装配中的传导将装配。由amkor开发的Powercsp™技术就是其中的概念之一.powercsp技术的一般传导密度密度在40-70%之间,因此因此外面观格可比传统功率封装小更多。
 图3。实施PowerCSP™技术显示显示它,以及若多结构结构。
图3。实施PowerCSP™技术显示显示它,以及若多结构结构。
在Powercsp技术中,其设计通讯同同和散热元件的铜晶片晶片晶片晶片晶片,使使能够使使全部和漏极区域。相较之下,它它区域。相较之下,它降低区域装配的电气和电池。包装的总传导密度发表作用,而为源极和漏极使使用全部界面也大大限制降低系统系统中的可爱损耗。

图7。使用于PowerCSP™(PCSP)的RDS,LDS及ciss和不用版本Ed2Pak,Toll及lfpak封装的模拟比较。
行业可以专营为功率装配开发其他其他装配概念,但封装配的传导密度将是关键词。不仅是si,gan或sic,它们都可以是衣服的传导传导加加而,包括电阻和电池的减小,以及最终缩小衣服的外观规格。附加包装传导密度的努力只帮助解决装装置的繁体功率密度问题,并利用si和wbg器材所所提供的全部优点。
关键作者
Shaun Bowers是Ambob体彩kor Technology,Inc。常驻位于亚利克坦佩的主流先进服装集副总监。他于2000年加入amkor,目前目前跑车,引引框架和功率装配业务。他过去还担任过技术项目管理、销售和客户服务等职务。在加入 Amkor 前,他曾在 Johnson Matthey Electronics 和 Honeywell Electronic Materials 就职。他持有贡萨格大学的机械工程学位。






