삼성전자,앰코테크놀로지와첨단H-Cube™공동개발
첨단반도체기술의세계적선두주자인삼정전자는HPC, AI,데이터센터등네트워크관련제품에특화된2.5 d패키지솔루션인하이브리드서브스트레이스큐브(H-Cube)기술개발을발표했습니다。
삼성전자파운드리사업부마켓전략팀강문수전무는”H-Cube는삼성전자와앰코테크놀로지,삼성전기(SMECO)가오랫동안협력해온결과로많은칩을집적해야하는고사양반도체에적합하다”며,“파운드리업계생태계를확장및강화함으로써고객이직면하는기술적한계를넘어서기위해다양한패키지솔루션을제공해나갈것"이라고밝혔습니다。
앰코테크놀로지글로벌研发부문의김진영상무는”집적화수준에대한요구가높아지고기판공급이제한된상황에서,삼성파운드리와앰코테크놀로지는이난관을극복하기위해함께H-Cube개발에착수해왔다”고말했습니다。김상무는또한이”개발은HPC / AI시장의진입장벽을낮추었고,파운드리와OSAT기업간의성공적인협업과파트너십사례가되었다”고논평했습니다。
H-Cube구조및특징
2.5 d패키징은로직칩또는고대역폭메모리(HBM)를소형폼팩터내부실리콘인터포저상단에배치될수있도록했습니다。삼성의H-Cube는고사양특성구현이용이한메인기판아래,대면적구현이가능한보조기판을추가로사용하는2단하이브리드패키징구조로,人类发展指数기판에대형2.5 d패키징을가능하게만들었습니다。
최근HPC, AI및네트워킹애플리케이션시장수요가강세를보이며,하나의패키지에탑재되는칩의수와크기가증가하고고대역폭통신이필요하기에대면적패키징이중요해지고있습니다。인터포저를포함한실리콘다이의부착및연결을위해서는파인피치기판이필수적이지만사이즈증가에따라가격도크게상승합니다。
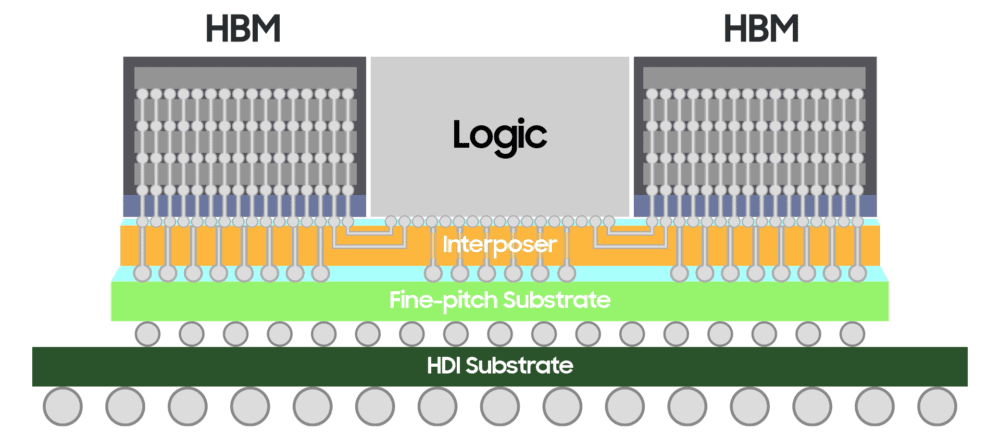
H-Cube™패키지구조
6개이상의HBM을집적할경우대면적기판제조의어려움이급격히증가하여효율성이감소됩니다。삼성은첨단파인피치기판아래대면적구현이용이한HDI기판을중첩한하이브리드기판구조를적용해이문제를해결했습니다。
솔더볼간격을기존보다35%감소시킨파인피치기판은하부에HDI서브스트레이트(모듈PCB)를추가함으로써시스템보드와의연결성을확보하였습니다。
또한,삼성은H-Cube신뢰도향상을위해여러로직과HBM을쌓으면서도칩에전원을안정적으로공급하고신호가손실되거나왜곡되지않도록칩분석기술도적용했습니다。



