이기종IC패키징:성능및비용최적화
반도체업계를선도하는집적회로(IC)파운드리기업들은이미나7노및5나노웨이퍼를출하하고,3나노제품검증도진행중입니다。고밀도트랜지스터는웨이퍼제조공정비용을상승시키기에웨이퍼비용은계속해서치솟고있습니다。새로운노드사용시결함밀도를비교적낮은수준으로유지할수있다고해도,실리콘의단위면적당비용은비선형적으로증가합니다。이러한경제성은미래제품구조에서새로운패키징기술을논의하게했습니다。
성능이가장중요한애플리케이션에새로운실리콘노드가제공하는트랜지스터밀도와클럭속도를활용하는방안을고려중입니다。그렇다면이것은최신실리콘노드를사용해성능을향상시킬필요가없는일반고성능다이의다른영역에는어떤영향을미칠까요?
그동안반도체업계는이기종패키징을정답으로여기면서,오랫동안신성하게우러러봐왔지만최근에들어서야설계방식실용화에성공했습니다。단일다이가될수있었던시스템온칩(SoC)의일부를균질한디자인으로부터깎아내서,더작은독립형실리콘다이를만든것입니다。첫번째추세는메모리,작용범위가넓은직렬/병렬(并行转换器)유형과통신하는입력/출력I / O블록을제거하는것이었습니다。
이렇게하면IC기능블록을반복적으로검증하고재사용할수있는전기적,기능적,물리적구성요소환경이조성됩니다。이러한방식으로최초의투자를수많은최종장치로분산시키는것은,불과몇년전만해도상상도할수없는일이었습니다。
반도체업계는2.5d실리콘관통전극(TSV제품들과함께새로운진화를시작했습니다。그덕분에동일한IC패키지에서특정애플리케이션을위한集成电路(ASIC)와함께초고밀도DRAM메모리또는고대역폭메모리(HBM)을적용할수있게되었습니다。이제기능블록으로서의이회로아이템들은SoC에서제거되고있습니다。그예로는독립형실리콘칩렛으로서의중앙처리장치(CPU), GPU,일반연산및고속IO블록등이있습니다。
이런발전에부합하기위하여소수또는다수의다이(로직또는.메모리)를고성능디스크리트다이컬렉션에통합하기위한핵심기술이몇가지개발되었습니다。종래의패키지기판을활용하는고밀도멀티다이제품,이른바멀티칩모듈(MCM)플립칩볼그리드어레이(FCBGA), 2.5 d TSV와고밀도팬아웃(HDFO)제품같은극도로섬세한구조가모두기술개발의결실입니다。현재는기판斯威夫特(s-swift)기술을활용하는새로운칩렛통합을검중입니다。S-SWIFT HDFO솔루션을채택하면2 -μm라인과2 -μm공간,6중레이어구조까지의미세라인라우팅을이용할수있습니다。지난3년간의발전을통해,이모듈제조기술은칩렛과HBM메모리를실제로통합할수있는수준까지향상되었습니다。S-Connect는HDFO와브리지의결합체이며현재내부검단계에있습니다。
칩렛을사용하는이기종구조구현에사용할IC패키징기술을선택하는데막대한영향을끼치는요소는칩렛들사이의통신인터페이스입니다(그림1참조)。다이들사이의IO가100年代또는1000年代인고속병렬인터페이스가많은애플리케이션에선호되며,이를위해서는실리콘인터포저나고밀도팬아웃(HDFO S-SWIFT),브리지기술(S-Connect)을사용하는2.5 d TSV와같은고밀도인터커넥트가필요합니다。
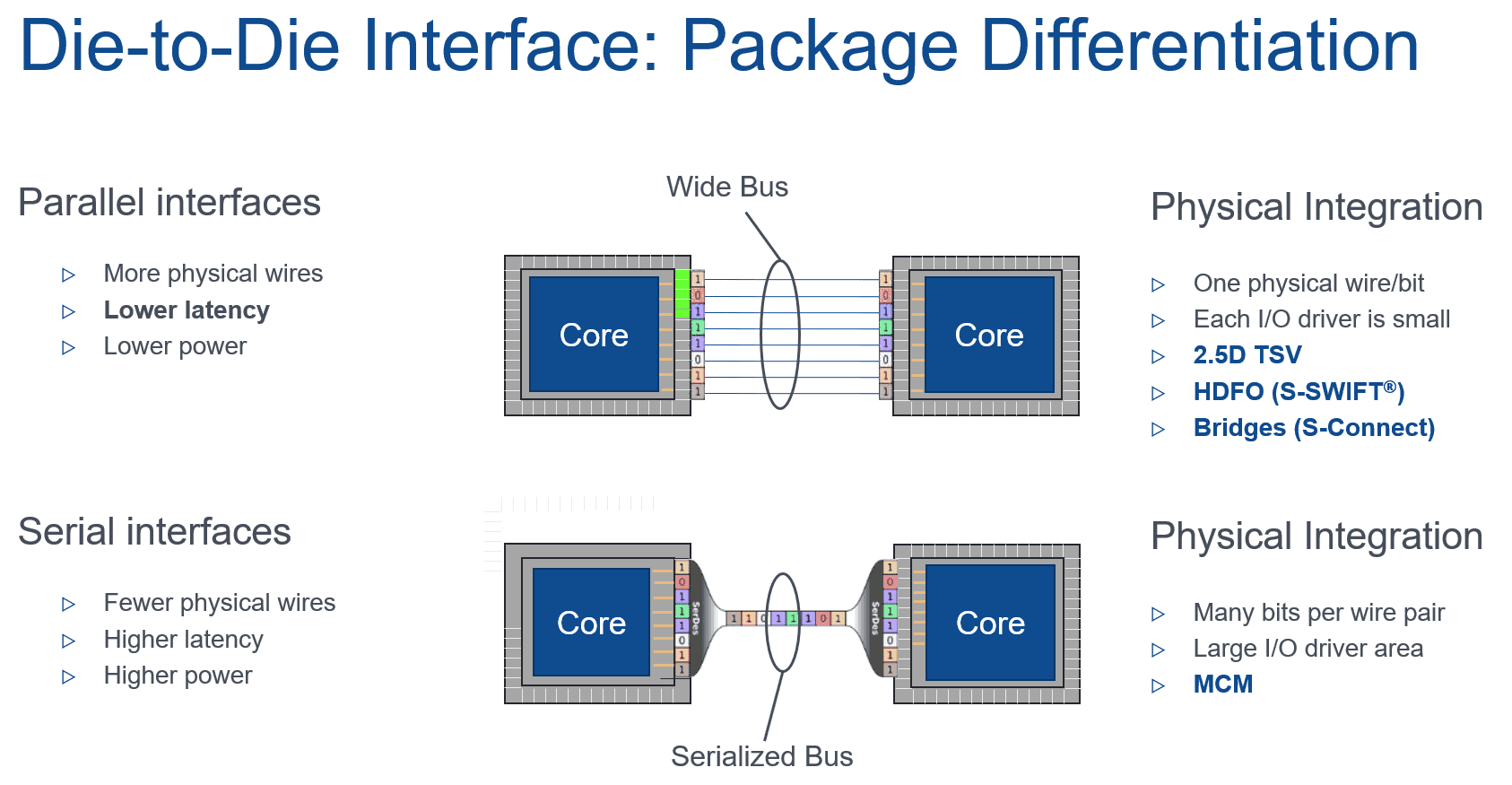
그림1:다이터페이스선택
S-SWIFT는구리미세라인포토리소그래피와유기유전체를사용하여현장에서생성하는신호라우팅밀도의수준을높입니다。S-Connect는이와동일한고밀도RDL기술을더드물게사용하지만,고밀도브리지를추가해서칩렛간의초고밀도라우팅을지원합니다。구리하이브리드본딩을통해구현하는초고밀도수직다이垫子다이상호연결을사용하는3d다이적층은앞으로도2d통합을보완하는。
이러한패키징기술은미래가유망합니다。칩렛의2d통합을위한신제품설계는작년에만4배演出가했습니다。실리콘아키텍처의유연성향상,칩렛재사용,시장출시속도단축,전반적인비용절감은앰코가이기종IC패키징로드맵에서발전을지속하는과정에서패키징업계에서의혁신을주도하는비결입니다。
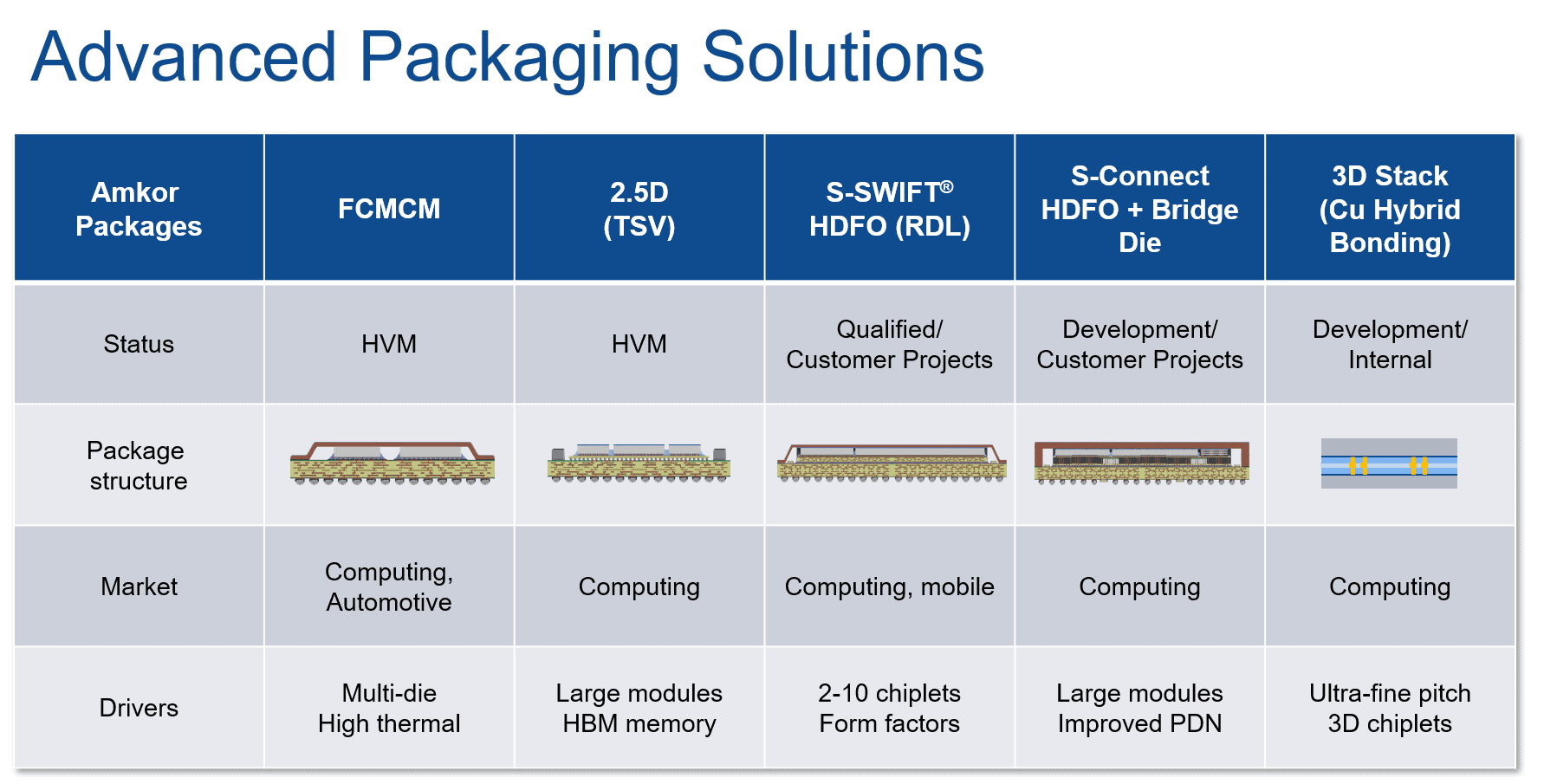
작성자정보
迈克凯利는앰코테크놀로지첨단패키지및기술통합부문이사로서2005년입사이래EMI차폐,열강화패키지,센서,2.5 d TSV와고밀도팬아웃(HDFO)을비롯한고밀도MCM패키지를위한패키지개발을주도해왔습니다。25년동안전자공학및IC패키지설계및제조분야에서경력을쌓으면서폴리에스터연성회로,공융(共晶)플립칩,IC패키지설계,신호무결성등다양한프로젝트를관리했습니다。또한반도체분야에서40개이상의특허를보유했고기계및화학공학석사학위를받았습니다。



