サムスン電子,最先端のH-Cube™ソリューションの開発でアムコー・テクノロジーと提携
最先端の半導体技術で世界をリードするサムスン電子は,高性能かつ大面積のパッケージング技術が求められるHPC, AI,データセンター,ネットワーク製品向けの半導体に特化した最新の2.5 dパッケージングソリューション“Hybrid-Substrate立方(H-Cube)”技術を開発したことを発表しました。
三星电子社のバイスプレジデント兼ファウンドリ市場戦略担当責任者,Moonsoo Kangは”サムスン・エレクトロ・メカニクス(SEMCO)とアムコー・テクノロジーが共同開発したH-Cubeソリューションは,多数のシリコンチップを集積する必要のある高性能半導体に適しています。”“ファウンドリーエコシステムを拡大・充実させることで,様々なパッケージソリューションを提供し,お客様が直面している課題の打開策を見つけていきます。“と述べています。
bob体彩安靠社のグローバル研发センター,シニアバイスプレジデント,JinYoung金正日氏は,“システムインテグレーションがますます求められ,基板の供給が制限されている今日の環境において,サムスンファウンドリとアムコー・テクノロジーは,これらの課題を克服するためにH-Cubeの共同開発に成功しました”“今回の開発は,HPC / AI市場への参入障壁を下げるものであり,ファウンbob软件ドリとOSAT (Outourced半导体组装和测试)企業のコラボレーションとパートナーシップの成功を示すものです”と述べています。
H-Cubeの構造と機能
2.5 dパッケージングでは,シリコンインターポーザーの上にロジックチップや高帯域幅メモリ(HBM)を小型で配置することができます。サムスンのH-Cube技術は,微細なバンプ接続が可能なファインピッチ基板と人类发展指数(高密度互连)基板を組み合わせたハイブリッド基板を採用し,2.5 dパッケージへの大容量化を実現しています。
近年,HPCやAI,ネットワークなどのアプリケーション市場分野で要求されるスペックの向上に伴い,1つのパッケージに搭載するチップの数や大きさが増えたり,広帯域の通信が必要になるなど,大面積のパッケージが重要になっています。インターポーザーをはじめとするシリコンチップのアタッチメントや接続には,ファインピッチの基板が不可欠ですが,サイズが大きくなると価格も大きく上昇します。
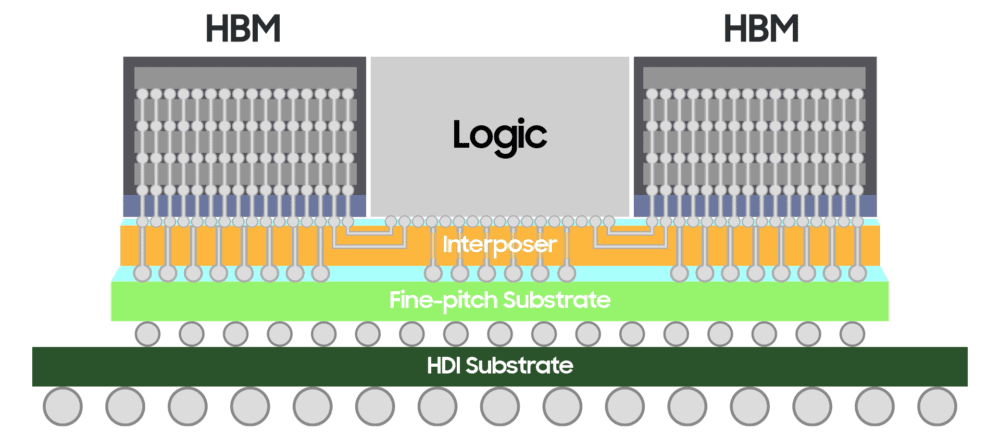
H-Cube™パッケージ構造のコンセプト
6個以上のHBMを内蔵する場合,大面積基板の製造難易度が急激に上昇し,効率が低下します。サムスンはこの問題を解決するため,大面積での実装が容易な人类发展指数基板を,ハイエンドのファインピッチ基板の下に重ねて配置するハイブリッド型サブストレート構造を採用しました。
チップと基板を電気的に接続するはんだボールのピッチを従来のボールピッチよりも35%小さくすることで,ファインピッチ基板のサイズを最小化するとともに,ファインピッチ基板の下に人类发展指数基板(モジュール基板)を追加することで,システム基板との接続性を確保しています。
また,H-Cubeソリューションの信頼性を高めるために,サムスンは独自のシグナル/パワーインテグリティ解析技術を用い,複数のロジックチップやHBMを積層する際に,信号の損失や歪みを最小限に抑えながら安定的に電力を供給することができました。



